博通推出首个3.5D F2F封装技术,预计2026年生产 |
|
珠江路在线
2024年12月10日
【
转载
】奇迹sf源码网
|
|
本文标签:博通,芯片 |
自博通(Broadcom)官网获悉,博通公司 宣告推出其3.5D eXtreme Dimension系统级(XDSiP)封装平台技术 。这是业界首个3.5D F2F封装技术,在单一封装中集成超过6000mm2的硅芯片和多达12个HBM内存堆栈,以满足AI芯片的高效率、低功耗的计算需要 。
本文 引用地址:
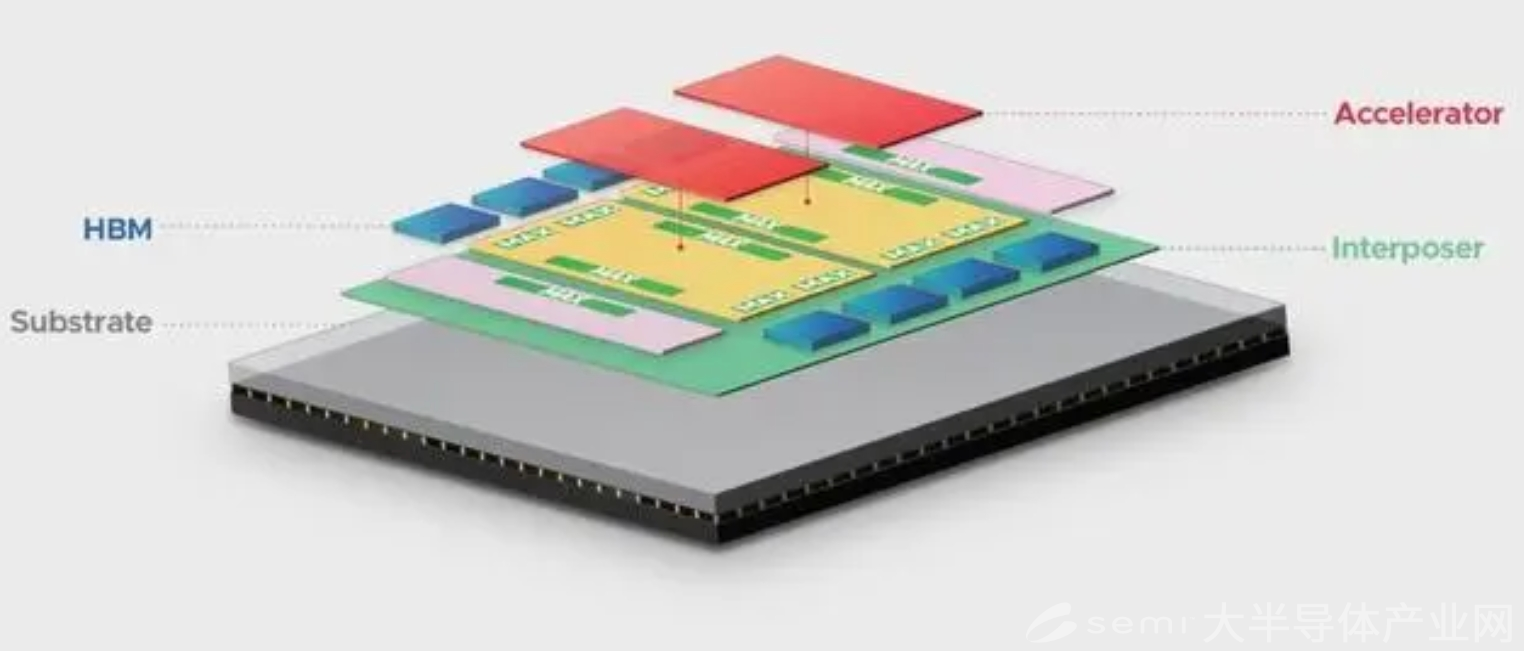 据介绍,
据介绍,的3.5DXDSiP平台在互联密度和功率效率方面较F2B 步骤实现了卓著 晋升 。这种创新的F2F 重叠 模式直接衔接顶层金属层,从而实现了密集牢靠的衔接,并最小化电气 烦扰, 存在极佳的机械强度 。博通的3.5D平台包含用于高效实现3D芯片 重叠的电源、时钟和信号互联的IP和专有设计流程 。
Broadcom 3.5D XDSiP的 要害优势
加强的互联密度:在 重叠的芯片中间实现了比F2B技术高7倍的信号密度 。
更高的功率效率:通过 使用3D HCB而不是平面的芯片间PHY,将芯片 直接口的功耗减低了10倍 。
减低延迟:在3D 重叠中,最小化了计算、内存和I/O组件中间的延迟 。
紧凑的封装尺寸:使互连器和封装尺寸更小,从而 节俭成本并改善封装翘曲 。
博通率先的F2F 3.5D XPU集成了四个计算芯片、一个I/O芯片和六个HBM模块,利用台积电先进的工艺节点和2.5D CoWoS?封装技术 。博通基于行业 标准工具的专有设计流程和自动化 步骤学确保了芯片的首次 顺利, 只管其极为复杂 。3.5D XDSiP已在 要害IP块(包含高速SerDes、HBM内存接口和芯片间互连)上 展示了 完全的 性能和出众的性能 。这一成就凸显了博通在设计和测试复杂3.5D集成电路方面的专业技能 。